TELEDYNE DALSA MEMS应用-硅通孔连接
- 关键词:Teledyne,DALSA,MEMS,硅通孔
- 摘要:Teledyne DALSA的Via-First TSV可以使用沟槽填充(原位掺杂的多晶硅)作为导体,如果需要更大的通孔,MEMS晶园本身可以作为导电区,而沟槽用作绝缘。在我们的150毫米和200毫米生产线都可以提供这项工艺。
MEMS应用
从手机的RF芯片,通讯光交叉连接到游戏控制器的陀螺仪,汽车压力传感器和用于汽车的惯性传感器到小型化的医疗系统用的微流体器件,Teledyne DALSA都已经量产,并且为这些创新的MEMS应用提高性能的同时降低尺寸和功耗。联系我们,讨论MEMS制造的挑战 Contact us today to discuss your MEMS fabrication challenges.
MEMS应用: 压力传感器 运动传感器 BioMEMS 微镜 硅通孔 射频MEMS
硅通孔连接
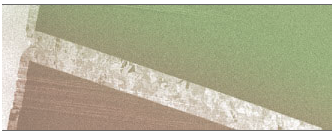
>>硅通孔应用于3D电路和晶圆级封装
使3D微电路成为可能
硅通孔连接TSV是3D集成MEMS的关键技术之一。他们通常归类为“Via-First”或“Via-Last”,两者的主要区别是Via-First制程是在晶圆键合之前,从而能够承受几百度的高温。Via-Last制程在晶园键合之后,并且通常需要涉及的温度必须足够低,以防止损坏后端CMOS层。
Teledyne DALSA的Via-First TSV可以使用沟槽填充(原位掺杂的多晶硅)作为导体,如果需要更大的通孔,MEMS晶园本身可以作为导电区,而沟槽用作绝缘。在我们的150毫米和200毫米生产线都可以提供这项工艺。
Teledyne DALSA的Via-Last技术采用铜通孔,使用Alchimer低温电化学填充。该技术制造出完美填充的仅5微米直径100微米深的通孔,并通过铜重分布层和镍/金UBM连接到外部。只有在我们200mm晶圆的线上可提供这个制程。
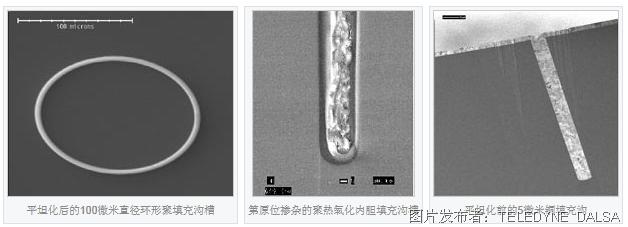
晶圆级封装(WLP) 表面贴装3D 集成电路使用晶圆级封装可以极大地降低芯片和封装尺寸,从而相应的降低成本,是为移动应用的理想选择。 Teledyne DALSA公司提供先进的输入输出连接选项,包括μBGA焊垫,或标准焊盘堆叠芯片和多片封装设计,可为振荡器,压力传感器和图像传感器,和非密封射频滤波器,微流体和硅麦克风等应用提供封闭型密封。 | 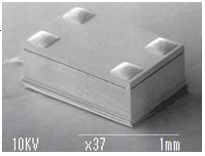 |


