破局先进封装检测瓶颈,华屹Athena HS4500实现一站式2D/3D检测与量测
在摩尔定律逐渐逼近物理极限的今天,先进封装技术已成为延续半导体产业发展的重要引擎。从 Chiplet异构集成到3D-IC堆叠,技术创新不断推动着电子设备向更高性能、更小尺寸、更低功耗迈进。然而,工艺复杂度的指数级增长,也为制造过程中的质量检测带来了前所未有的挑战。
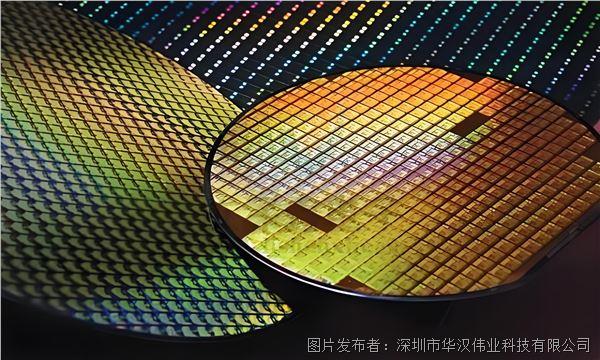
行业挑战
从传统封装到先进封装,AOI检测设备的应用场景不断拓展,市场需求持续增长。晶圆级封装、2.5D/3D集成等技术的复杂性与精度需求日益提升,对检测设备提出了更高的要求。传统检测手段难以兼顾高效率与高精度,尤其在面对Bumping、晶圆切割和RDL等关键工艺环节,往往力不从心。如何在同一平台上实现快速、精准且全面的缺陷发现与测量,成为行业亟待突破的痛点。
面对先进封装市场的技术挑战,华屹超精密推出的Athena HS4500先进封装AOI检测设备应运而生。Athena HS4500专为先进封装市场设计,创新性地将EFEM、2D视觉、3D视觉、AI模块整合于同一平台,实现了2D和3D检测与测量的一体化解决方案,在保证极高检测性能的同时显著提升了检测效率。

产品亮点
1、晶圆缺陷全捕捉
涵盖裸晶圆及切割后晶圆等多种状态,对各类常见缺陷进行有效识别。
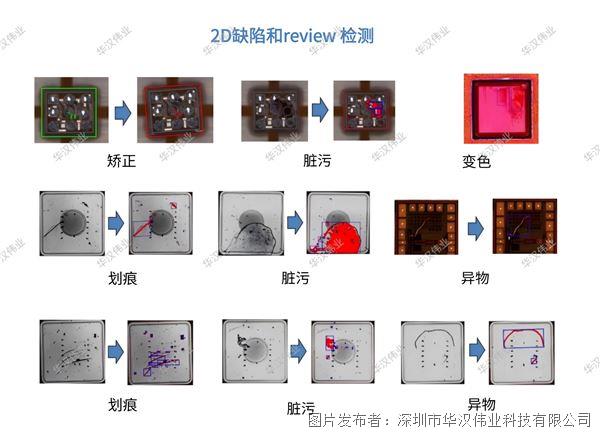
2、Bump检测零死角
支持多种Bump类型,实现高度与共面度的精准检测和测量。
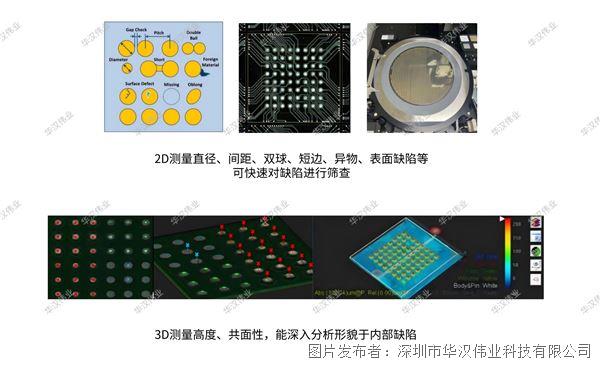
3、RDL 精细化检测
可对 RDL CD、高度及表面缺陷进行检测,支持最小2x2μm L/S。
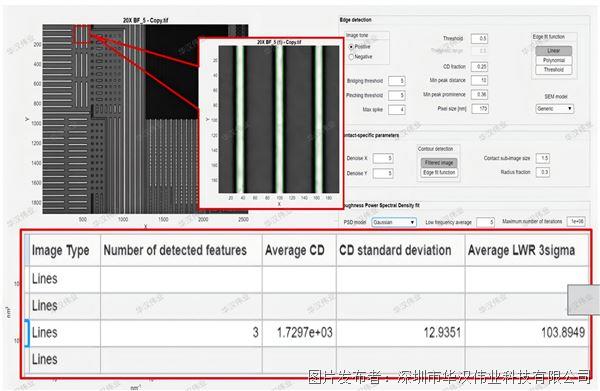
主要指标
• 兼容板级@510mm*515mm、晶圆级@6"、8"、12"
• 0.1-1.5mm来料厚度
多模态光学方案
Athena HS4500 搭载创新的多模态光学系统,为不同检测需求提供最优解决方案:
l2D 检测系统
•采用明场+暗场双光路成像技术
• 明场成像:提供清晰的表面形貌信息,实现精确的尺寸测量和形状分析
• 暗场成像:凸显微细划痕、颗粒污染等微弱缺陷,大幅提升缺陷发现能力
• 双模式协同工作,实现对表面缺陷的全方位捕捉和精准分类
l3D 量测系统
• 集成白光干涉(WLI)和共聚焦(CFM)双测量模式
• 白光干涉技术:实现大范围的快速扫描,适用于 bump 高度、共面性等宏观参数测量
• 共聚焦技术:完成高精度的微观形貌测量,分辨率可达纳米级别
• 两种技术无缝切换,满足从宏观到微观的不同量测需求
lIR 检测系统
•能够实现隐裂检测和背部缺陷识别
•支持三维堆叠结构的内部缺陷检测
•解决传统检测设备“看得见表面、看不见内部”的痛点
在当前全球半导体产业格局深刻变革的背景下,先进封装技术正成为推动产业发展的关键突破点。随着制程工艺不断逼近物理极限,异构集成、芯片let等新技术路径对检测设备提出了更高要求——不仅需要纳米级的检测精度,更需要实现多维度、全流程的质量监控能力。
面对这一历史性机遇,华屹超精密将继续深耕半导体领域,以技术创新为产业赋能。同时,我们将积极与产业链上下游企业协同创新,为半导体产业的高质量发展提供坚实支撑。
提交
【展会邀请】共探“芯”突破,华屹与您相约SEMI-e 2025
【展会回顾】CSEAC 2025:行而不止,以华屹力量创“芯”向未来
【展会邀请】芯之所向,共探未来!华屹邀您共赴CSEAC 2025半导体设备年会
破解先进封装AOI检测痛点,华屹Athena HS4500首秀在即!
【产品速递】华屹TGV蚀刻后AOI检测设备: 全维度守护通孔结构精度








 投诉建议
投诉建议




